產品介紹

1. 最豐富的擴充功能 ---- 滿足所有研究需求
2. 最實惠的高效平板掃描器 ---- 將壓電掃描管易有的bow effect降至最低,提升量測準確度
3. 獨特非接觸式掃描設計----提升探針壽命,降低樣品損傷風險
4. TSMC認可採用品牌 ---- 讓您使用更放心
5. 人性化的操作介面與方便的探針安裝與校正體驗
目的:
提供三維表面形態影像,包括表面粗糙度、粒徑大小、高度差和間距
除此之外能提供高階AFM應用所擁有的所有選配功能,包含C-AFM, KPFM, PFM, SCM等。
品牌: Park Systems (韓國)
型號: NX7
樸實的外表,
不凡的內在。
每一次的量測都值得信賴,
每一次的操作都感覺自在 。
匠心獨具的NX7,
來自韓國大廠 Park Systems ,
具備了所有高階AFM該有的功能及效能,
然而您可用相對實惠的價格擁有它。
The most affordable research grade AFM with flexible sample handling
Park NX7 has all the state-of-the-art technology you have come to expect from Park Systems, at a price your lab can afford. Designed with the same attention to detail as our more advanced models, NX7 allows you to do your research on time and within budget.
The Most Extensible AFM Solution
Supports Park’s most extensive range of SPM modes and options in the industry

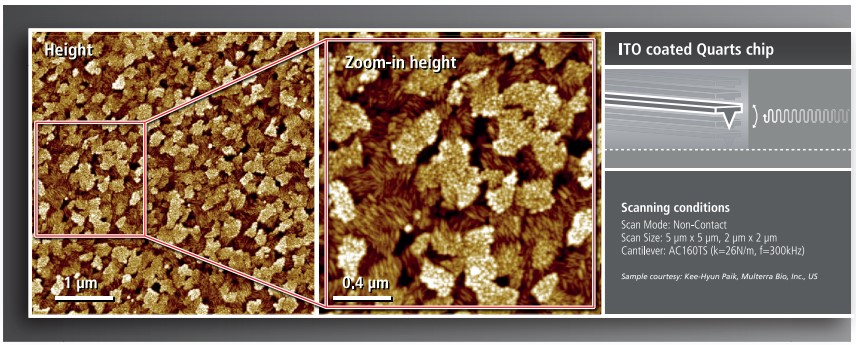
Accurate XY Scan by Crosstalk Elimination
- Two independent, closed-loop XY and Z flexure scanners
- Flat and orthogonal XY scan with low residual bow
- Accurate height measurements without any need for software processing
The Most Extensible AFM Solution
- The most comprehensive range of SPM modes
- Advanced nanomechanical measurement modes are supported as default enabled by NX electronic controller
- The best option compatibility and upgradeability in the industry
User Experience-Driven Software and Hardware Features
- Open side access for easy sample or tip exchange
- Easy, intuitive laser alignment with pre-aligned tip mount
- Park SmartScanTM - AFM operating software versatile enough to empower both novices and power users alike toward great nanoscale research
Flat Orthogonal XY Scanning without Scanner Bow
Park's Crosstalk Elimination scanner structure removes scanner bow,
allowing flat orthogonal XY scanning regardless of scan location, scan rate, and scan size.
It shows no background curvature even on flattest samples, such as an optical flat, and with various scan offsets.
This provides you with a very accurate height measurement and precision nanometrology
for the most challenging problems in research and engineering.
Decoupled XY and Z Scanners
The fundamental difference between Park and its closest competitor is in the scanner architecture. Park’s unique flexure based independent XY scanner and Z scanner design allows unmatched data accuracy in nano resolution further improved with NX AFM Head (Z scanner) powered by NX AFM electronic controller.

Industry Leading Low Noise Z Detector
Park AFMs are equipped with the most effective low noise Z detectors in the field,
with a noise of 0.02 nm over large bandwidth. This produces highly accurate sample topography and no edge overshoot.
Just one of the many ways Park NX series saves you time and gives you better data.

Accurate Sample Topography Measured by Low Noise Z Detector
- Uses low noise Z detector signal for topography
- NX electronic controller provides low Z detector noise of 0.02 nm over large bandwidth
- Has no edge overshoot at the leading and trailing edges
- Needs calibration done only once at the factory
Sample: 1.2 μm Nominal Step Height
(9 μm x 1 μm, 2048 pixels x 128 lines)
Better tip life, sample preservation, and accuracy with True Non-Contact™ Mode
True Non-Contact™ Mode is a scan mode unique to Park AFM systems that produces high resolution
and accurate data by preventing destructive tip-sample interaction during a scan.
Unlike in contact mode, where the tip contacts the sample continuously during a scan, or in tapping mode,
where the tip touches the sample periodically, a tip used in non-contact mode does not touch the sample.
Because of this, use of non-contact mode has several key advantages.
Scanning at the highest resolution throughout imaging is now possible as the tip’s sharpness is maintained.
Non-contact mode avoids damaging soft samples as the tip and sample surface avoid direct contact.
Accurate Feedback by Faster Z-servo enables True Non-Contact AFM
- Less tip wear → Prolonged high-resolution scan
- Non-destructive tip-sample interaction → Minimized sample modification
- Maintains non-contact scan over a wide range of samples and conditions
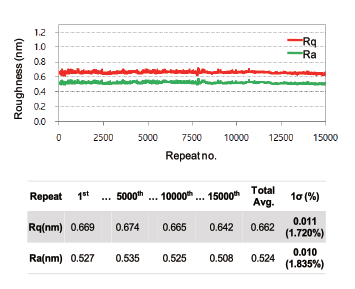
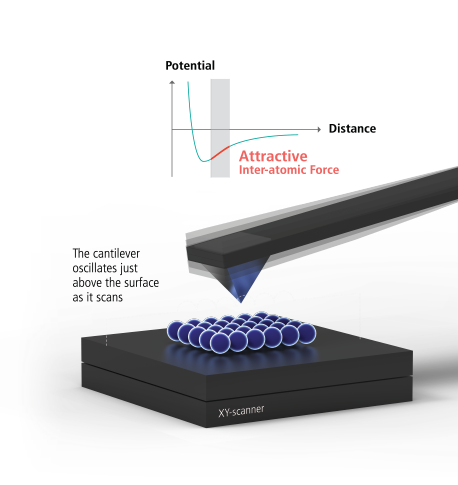
Furthermore, non-contact mode senses tip-sample interactions occurring all around the tip.
Forces occurring laterally to tip approach to the sample are detected.
Therefore, tips used in non-contact mode can avoid crashing into tall structures that may suddenly appear on a sample surface.
Contact and tapping modes only detect the force coming from below the tip and are vulnerable to such crashes.
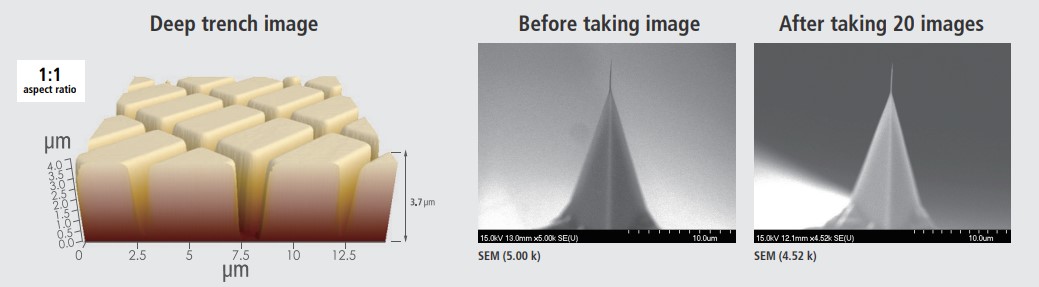
Park NX7 Specifications
Scanner
Z Scanner
Flexure guided high-force scanner
Scan range: 15 µm (optional 30 µm)
XY scanner
Single module flexure XY-scanner with closed-loop control
Scan range : 50 µm × 50 µm
(optional 10 µm × 10 µm or 100 µm × 100 µm)
Stage
XY stage travel range: 13 mm x 13 mm (Manual)
Z stage travel range: 26 mm (Motorized)
Focus stage travel range: 30 mm (Manual)
Sample Mount
Sample size : Up to 50 mm x 50 mm, Thickness Up to 20 mm
On-Axis Optics
Direct on-axis vision of sample surface and cantilever
Field-of-view : 480 × 360 µm (with 10× objective lens)
CCD : 1.2 M pixel, 5 M pixel (optional)
(optional; Field-of-view: 840 µm x 630 µm)
Software
SmartScanTM
- AFM system control and data acquisition software
- Auto mode for quick setup and easy imaging
- Manual mode for advanced use and finer scan control
SmartAnalysisTM
- AFM data analysis software
- Stand-alone design—can install and analyze data away from AFM
- Capable of producing 3D renders of acquired data
Electronics
Integrated functions
4 channels of flexible digital lock-in amplifier
Spring constant calibration (Thermal method)
Digital Q control
Options/Modes
Force Measurement
Dielectric/Piezoelectric Properties
Electric Force Microscopy (EFM)
Piezoresponse Force Microscopy (PFM)
PFM with High Voltage*
Mechanical Properties
Force Modulation Microscopy (FMM)
Nanoindentation
Nanolithography*
Nanolithography with High Voltage*
Nanomanipulation*
Magnetic Properties
Chemical Properties*
Chemical Force Microscopy with Functionalized Tip
Electrochemical Microscopy (EC-AFM)
如對此AFM有何技術上之問題或委測需求,歡迎來電: 02-2793-3133 或MAIL至 david.chang@utekmaterial.com
我們將為您提供最即時的諮詢與技術服務。